들어가기 앞서,,,
Isotropic과 Anisotropic에 대해 araboja
Isotropic 이란 등방성 식각으로
- 큰 지오메트리에서 적합하며, 사이드월 경사가 중요하지 않고 마스크 언더컷이 필요한 경우에 가장 적합하다.
- 측벽은 곡석 또는 경사면이다.
- 빠르고 간단하며 비용이 저렴하다.
Anisotropic 이란 이방성 식각으로
- 좁은 간격과 수직에 가까운 측벽이 필요한 경우에 가장 적합하다.
- 수직 측벽 생성 가능
- 식각이 주로 수직 방향으로만 일어남
- 일반적으로 비용이 더 높다.
Sidewall Slope : Isotropic Etching
Isotropic 식각으로도 거의 수직에 가까운 측벽을 만들 수 있다.
그러나 보통은 Anisotropic 식각으로 수직 측벽을 만든다!
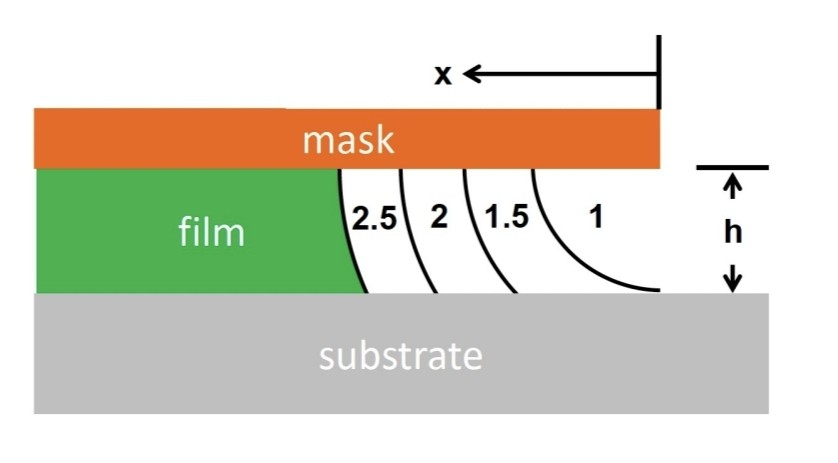
Wet vs Dry Etch
주요 내용들을 비교하자면 다음과 같다.
Selectivity ; 선택성
- dry etch : 낮음
- wet etch : 높음
typical etch rate ; 일반적인 식각 속도
- dry etch : 낮음
- wet etch : 높음
control of etch rate ; 식각 속도 제어 용이성
- dry etch : 용이함
- wet etch : 어려움
Directionality ; 방향성
- dry etch : 대부분의 재료에서 방향성 제어 가능
- wet etch : 단결정 재료에서만 방향성 제어 가능
Mask layer adherence ; 마스크 층 접착 중요도
- dry etch : 덜 중요함
- wet etch : 매우 중요함
Operation parameters ; 공정 변수 수
- dry etch : 많음
- wet etch : 적음
Isotropic Wet Etching
모든 방향으로 동일한 속도로 식각된다
- 결과:
- 날카로운 모서리나 가장자리를 둥글게 만듦
- 거칠기나 손상된 표면을 매끄럽게 정리할 수 있음
적용 가능한 재료
-
항상 등방성 식각이 가능함
-
단결정 재료
- 조건에 따라 가능
즉, 등방성 식각은 모든 방향에서 균일하게 식각되며, 표면의 거칠기 제거에 유리하다. 비정질 및 다결정 재료에서는 항상 적용이 가능하며 단결정 재료는 조건에 따라 가능하다.
Etch Parameters in Wet Etching
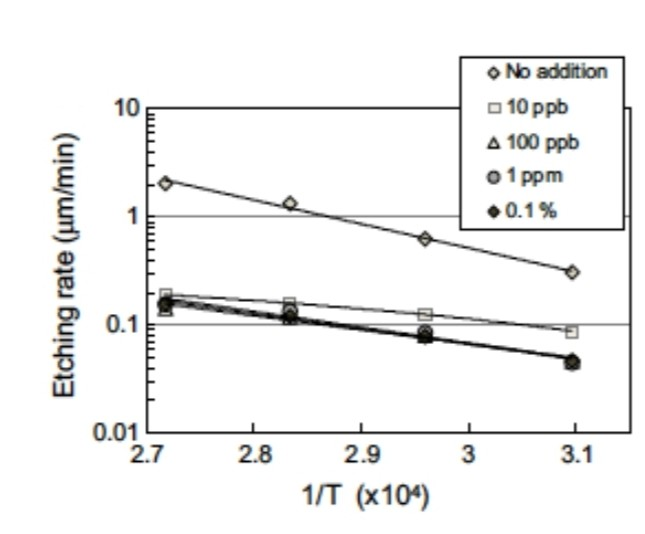
Etch rate
- 재료 제거 속도
- 농도, 혼합 상태, 온도의 함수로 결정됨
- 아레니우스 관계식을 따름
=> 일반적으로 식각 속도는 온도 상승 시 지수적으로 증가함
=> 식각 속도 형태이다.
Etch selectivity
- 식각 속도의 비율로 정의됨
- 특정 박막에 대한 식각 속도를 마스크, 기판, 다른 박막에 대한 식각 속도와 비교한 비 (ratio)
Etch Geometry(식각 형상)
- 측벽 기울기 또는 이방성의 정도
- 수직에 가까울수록 이방성임
- 둥글거나 경사진 형태일수록 등방성
Wet etching
이번 포스팅의 핵심인 Wet etching에 대해 araboja
-
습식 식각의 일반적 특성
- 다양한 재료를 식각할 수 있음 (범용성이 높다)
- 산, 염기, 물의 혼합물로 구성됨
- 습식 식각의 식각 속도
- 식각 속도 범위가 매우 넓음
- 사용된 화학물질, 농도, 온도, 혼합 상태에 따라 식각속도가 크게 달라진다.
- 식각 속도 범위가 매우 넓음
-
습식 식각의 식각 선택성
- 일반적으로 매우 높은 선택성을 가진다
- 원하는 재료만 식각하고, 마스크나 다른 층은 손상시키지 않는다
- 일반적으로 매우 높은 선택성을 가진다
-
습식 식각과 요염
- 미세한 이물질, 금속 이온, 용해 불순물 등으로 인해 선택성이 급격히 저하될 수 있다.
-
습식 식각의 형상
- 일반적으로 등방성 식각
- 모든 방향에서 균일하게 식각됨 (날카로운 모서리가 둥글게 변함)
- 특수 조건에서는 이방성 식각도 가능하다
- 결정 방향성과 반응성을 이용하거나 특정 공정조건(온도, 농도, agitation 등을 제어하면 수직 측벽도 가능)
- 일반적으로 등방성 식각
Mechanics of Etching process
식각 공정의 기초 공정 매커니즘 6단계
-
Etchant Species Generation (식각 종 생성)
- 식각에 필요한 반응성 물질 (ex: 라디칼, 이온 분자 등을 생성하는 단계)
- 예를 들면 플라즈마 내에서 기체가 분해되어 반응성 라디칼을을 생성
-
Diffuse to Surface (표면으로 확산)
- 생성된 식각종이 식각하려는 웨이퍼 표면까지 이동
- 기체 또는 액체 상태에서 확산을 통해 이동함
-
Adsorption (흡착)
- 식각종이 웨이퍼 표면에 부착되어 머무는 과정
- 충분한 시간과 에너지를 갖고 표면에 머물러야 이후 반응이 가능
-
Reavtion (화학 반응)
- 흡착된 식각종이 표면 재료와 반응하여 휘발성 또는 제거 가능한 생성물 생성
- 실제로 재료가 깎이는(제거되는) 본질적인 단계
-
Desorption (탈착)
- 반응 후 생성된 부산물이 표면에서 떨어져 나오는 과정
- 생성물이 남아 있으면 식각이 멈추므로 효율적인 탈착이 중요함
-
Diffuse to Bulk
- 탈착된 부산물이 주변 매질(기체나 액체)로 빠져나가 전체 시스템으로 확산됨
- 제대로 제거되지 않으면 오염이나 식각률 저하 유발
=> 이 매커니즘은 습식 및 건식 식각 모두에 적용되며 주로 반응성 이온 식각이나 플라즈마 식각에서는 이 과정을 더 세밀하게 제어한다.
Slowest step dominates
가장 느린 단계가 전체 식각 속도를 결정한다.
그렇다면 각 단계가 가장 느릴 경우엔 어떻게 될까?
- Etchant Species Generation (식각 종 생성)
- 전체 식각 속도가 느려질 것이다.
=> 반응성 종이 충분히 생성되지 않기 때문에 공정 전체가 지연된다.
- 전체 식각 속도가 느려질 것이다.
-
Diffusion to Surface (표면으로의 확산)
-
식각 속도는 혼합에 매우 의존하지만, 온도에는 큰 영향을 받지 않는다
=> 교반이 잘 되어야 하고, 유체 흐름이 중요 -
또한 레이아웃과 기하 구조(lay out 및 geometry)에 따라 식각 속도가 영향을 받는다.(의존한다)
=> ex : 좁은 공간이나 복잡한 패턴에서는 확산이 어렵기 때문이다.
-
-
Reaction (화학반응)
- 식각 속도는 온도에 매우 의존하고 혼합이나 레이아웃 및 기하구조에는 의존하지 않는다
=> 온도가 높을수록 반응 속도가 증가한다
- 식각은 매우 균일할 것이다.
=> 반응이 지배적일 경우, 전체적으로 고른 식각 품질을 기대할 수 있음.
- 식각 속도는 온도에 매우 의존하고 혼합이나 레이아웃 및 기하구조에는 의존하지 않는다
Diffusion to Bulk
식각 공정에서 확산이 느릴때 식각 속도에 어떤 영향을 줄까?
-
Diffusion to Bulk (벌크로의 확산)
- 식각속도는 혼합(mixing)에 매우 의존적이지만 온도에는 의존하지 않음
- 또한 레이아웃 구조와 geometry에 따라 식각 속도가 달라진다.(의존한다)
즉 반응 생성물이 벌크로 빠져나가는 과정이 느리면 식각 반응이 지연된다. 이때는 잘 저어주거나 유동을 만들어주면 개선된다.
-
Diffusion to Surface & Diffusion to Bulk (표면과 벌크로의 확산)
-
식각 속도 결정 -> 확산 속도에 의해 제한됨
-
젓기가 식각 속도를 증가시킬 수 있다.
- 더 낮은 활성화 에너지를 가지고 있음- 따라서 온도를 높이는 유인이 적다 (온도보다 유동이 더 중요하므로)
-
확산이 느려서 식각 속도가 제한되는 경우엔, 온도보다도 혼합이나 흐름제어가 더 중요하다는 의미이다.
즉, 온도에 의존하지 않으므로 온도를 올릴 유인이 적다.
Slowest step still Dominates...
You have an etchant that attacks the green material

어느 영역이 가장 많이 식각되었는가?
- 1번과 3번 영역은 같은 속도로 식각되었다.
- 2번 영역은 렌즈 형태로 식각되었다.
- 이는 노출된 면적 차이 때문이다.
- 식각 속도는 같았지만 모든 영역이 동일한 속도로 식각되었음에도 불구하고 발생한 결과이다.
Etch Rate Variation ; 식각 속도 편차
공정 중 식각 속도가 일정하지 않고 위치나 조건에 따라 달라지는 현상을 말한다.
설정 조건 관련
- 온도 및 혼합 상태
- 반응성 물질의 손실, 증발로 인한 액체 손실
- 인가된 전위, 조명
- 식각 생설물이 화학물 흐름을 막거나 오염을 유발
식각 대상 재료 관련
- 재료 내 불순물
- 미세 구조
- 박막 응력
레이아웃 및 구조 관련
- 노출된 표적 레이아웃의 표면 면적 분포 및 비율
- 구조적 형상
로딩 효과
- 한 영역에서 더 많은 재료가 식각될 때 식각 속도가 느려지는 현상

-
더 빨리 제거된다.
-
로딩 효과로 인해 식각 속도가 감소한다.
- 식각 생성물이 표면에 머물면서 식각 속도를 떨어뜨릴 수 있다.
Challenges with Wet Isotropic Etching
다른 식각 방식들과 마찬가지로, 습식 Isotropic etching도 몇 가지 어려움을 가지고 있다.
- 높은 정밀도를 위한 적절한 마스크 소재를 찾는 것
- 식각 속도가 교반에 민감함
- 식각 속도가 온도 변화에 민감함
Isotropic Etchant ; 등방성 식각제
등방성 식각제는 어떤 식각제 일까?
- 대부분 산이다. ex. 불산, 질산, 아세트산, 염산, 인산, 황산
- 둥근 형상을 생성한다.
- 낮은 온도에서 사용된다
- 보통 확산 제한 특성을 가진다
- 선택적 식각은 도펀트 의존 식각을 통해 서로 다른 식각 속도를 만들어낸다.
불산 (Hydrofluoric acid, HF)
민감함 (상온에서도 반응)
- SiO₂는 식각하지만 Si는 식각하지 않음
- 또한 Al, SiₓNᵧ 등도 공격함
식각 속도는 농도에 강하게 의존
- 최대 농도: 49% HF
- 제어된 농도: 5:1 또는 50:1 (물과의 희석 비율)
매우 위험함!
- 강산은 아니지만
- 겉보기엔 물과 비슷해 속이기 쉬움
- 피부를 뚫고 흡수되며, 천천히 반응함
- 뼈를 침투하여 손상시킬 수 있음
식각 형상
- 완전한 등방성 식각 (isotropic etching)
- 주로 언더컷(Undercut) 또는 릴리즈(Release) 용도로 사용됨
인산 (Phosphoric acid, H₃PO₄)
선택적 식각 특성 (상온 기준)
- SiₓNᵧ는 식각하지만 Si, SiO₂는 식각하지 않음
- Al 및 기타 금속도 공격할 수 있음
식각 속도
- 고온(예: 160°C)에서 느린 속도로 식각 (예: 약 0.005 μm/min 수준)
마스크 재료 필요
- PR(포토레지스트)은 고온에서 견디지 못함
- 일반적으로 산화막(Oxide layer)이 마스크로 사용됨
식각 형상
- 완전한 등방성 식각 (Isotropic etching) 특성을 보임
HNA (HF/질산/아세트산 혼합물)
식각 대상
- 실리콘(Si)을 식각하는 데 사용됨
구성 성분 및 작용 메커니즘
- 질산(HNO₃)과 불산(HF)의 혼합물이며, 경우에 따라 아세트산(CH₃COOH)으로 희석
- 질산(HNO₃)은 Si을 산화시켜 SiO₂를 생성하고,
불산(HF)은 생성된 SiO₂를 제거
→ 이 과정을 반복하여 Si이 지속적으로 식각됨
혼합비에 따른 식각 메커니즘 변화
1. HNO₃ : HF 비율이 낮을 경우 → 산화 속도가 느려 식각 속도 제한 요인이 됨
2. HNO₃ : HF 비율이 높을 경우 → 산화는 빠르나 산화막 제거가 느려 식각 속도 제한 요인이 됨
3. 비율이 적절한 구간 → 식각 속도가 최대치에 도달함
희석
- 물(H₂O)이나 아세트산(CH₃COOH)으로 희석하여 식각 특성 조절 가능
식각 형상
- 완전한 등방성 식각 (Fully isotropic etching)

인산(Phosphoric acid)은 인은성 家가 가진 뒷산인가요?