이 velog는 데이터분석과 인공지능을 공부하기 위해 만들어 졌으나 반도체공정 시험이 코앞으로 다가와서 첫포스팅은 불가피하게 이것으로 대체하겠습니다.
Etch 공정의 정의
-Process that removes material from surface
표면에 있는 물질들을 제거하는 과정이다.
-Chemical, physical of combination of the two
화학적인 방법으로 식각하거나 물리적인 방법으로 식각하는 방법이 있다.
-Selective or blanket etch
선택적으로 식각하거나 전체적으로 식각하는 방법이 있다.
-Selective etch transfer IC design image on the PR to the surface layer on wafer
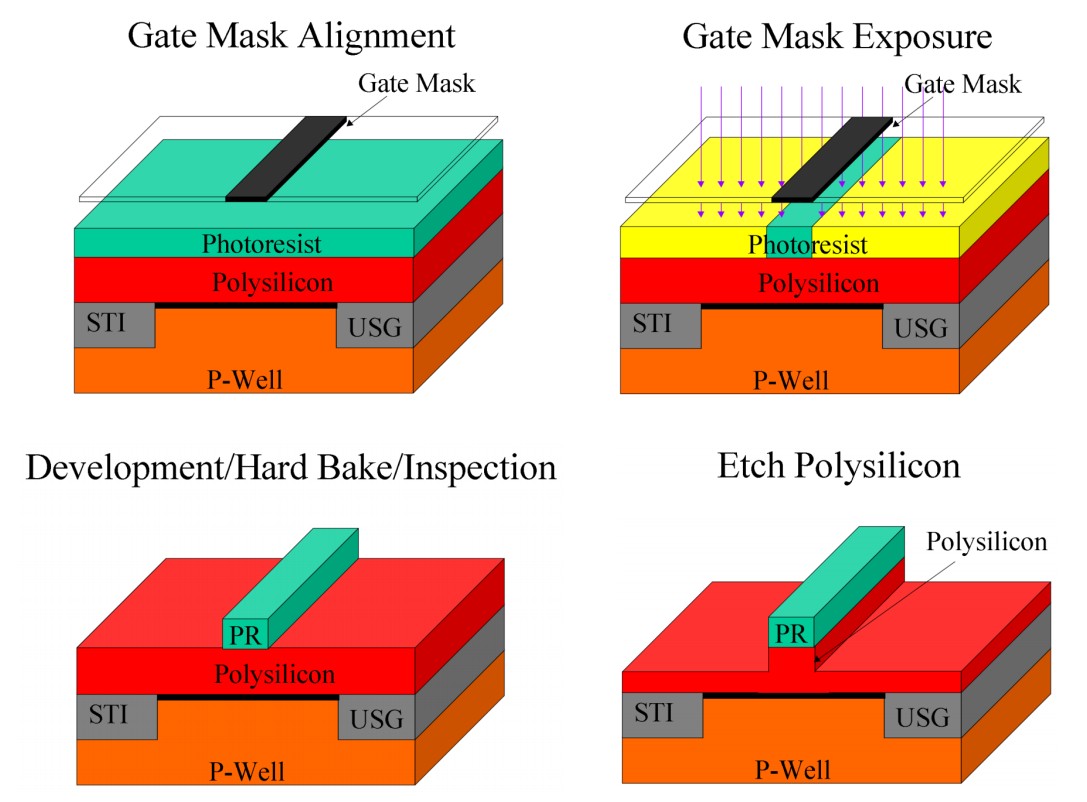
처음에 mask를 이용하여 PR을 씌우고 hard bake를 하고 식각하는 과정을 그림으로 일괄적으로 표현한 모습이다.
Etch Polysilicon이 이번주에 중점적으로 다룰 내용이다. 식각은 물질을 깍아 내려가는 과정으로 밑으로 깍아 내려가는데 각 물질마다 깍이는 속도가 달라 어디까지 깍아야되고 멈춰야되는지 잘 모를때가 많다. 이제 깍는것을 멈쳐야된다는 신호를 주기 위해서 polysilicon과 아래의 기판 사이에 sio2를 얇게 박막시켜 이제 멈춰야 된다는 것을 인지 시킨다.
식각공정 개념들
- Etch rate
- Selectivity
- Etch uniformity
- Etch profile
- Wet etch
- Dry etch
- RIE
- Endpoint
Etch rate
1초(분)당 박막이 몇 암스토롱씩 없어지는가??
Etch rate = Thickness change after etch/etch time
Selectivity
Selectivity is the ratio of etch rates of different materials.
Selectivity to underneath layer and to photoresist
S=E1/E2
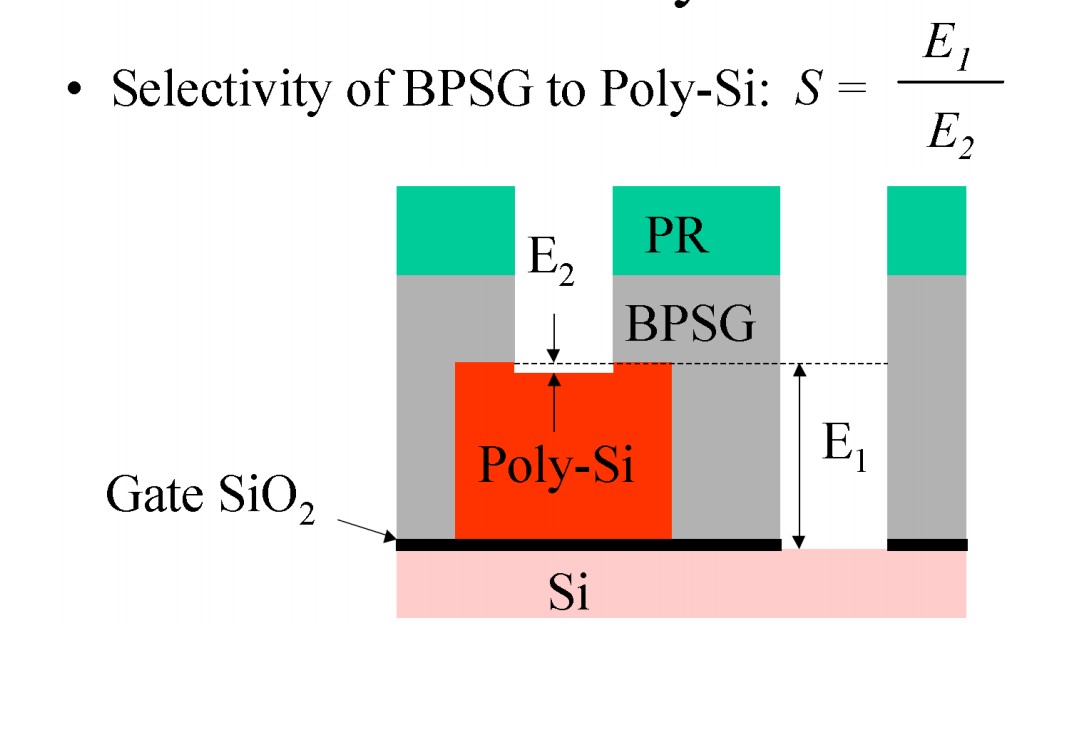
Poly silicon을 E2만큼 깍을때 BSPG를 E1깍을때 비율을 Selectivity 라고 하며 클수록 좋다.
Etch Profiles
대표적으로 Anisotropic(비등방성)과 Isotropic(등방성)이 있으며 비등방성중에 foot,reversed foot,reversed tapered, undercut이 있다.
Wet Etch
-액체 상체의 화학용액으로 식각시키는 방법이다.(주로 HF용액을 이용)
-wet etch로 인하여 가스, 액체 등 식각으로 용해되서 생기는 부산물이 만들어 진다.
-등방성의 특징이 있다.
-3 micron보다 큰 물질에서 이루어진다. 더 작으면 등방성의 성질로 인하여 제대로 된 역할을 하지 못하게된다.
-높은 selectiviy를 가지고 있다.
-wet etch공정에서는 식각되는 속도를 기반으로 CVD의 질적수준파악을 알 수 있다.
이를 바탕으로 CVD film의 성질을 평가해 볼 수 있다.
SiO2 + 6HF -> H2SiF6 + 2H2O
-sio2를 식각할때 wet etch과정의 화학식이고 H2SiF6는 표면에서 물에 녹아 떨어져 나온다.
Si+2HNO3+6HF -> H2SiF6+2HNO2+2H20
-silicon을 식각할때 wet etch과정의 화학식이고 HNO3 과 HF를 섞어서 etch시킨다.
Si3N4+4H3PO4 -> Si3(PO4)4+4NH3
-LOCOS 공정이나 STI를 만들때 사용하는 nitride를 식각하기 위해서 4H3PO4(인산)을 사용한다. 인산은 sio2나 silicon을 식각시키지 못하며 오로지 nitride만 식각시킬수 있어서 밑에 기판이나 silicon같은 다른 물질에 데미지를 주지 않는다.
