<전문가 기고>
1. 칩의 세계는 관식이 마음이랑 달라요 - 1탄
2. 칩의 세계는 관식이 마음이랑 달라요 - 2탄
CPU, GPU, HBM

1. CPU (Central Processing Unit, 중앙처리장치)
-
컴퓨터 시스템의 중심이 되는 프로세서로, 모든 명령어 처리를 담당하는 연산 장치입니다.
-
역할: 운영체제와 프로그램에서 내려진 명령을 해석, 연산, 제어합니다.
-
특징
-
연산 유닛(산술논리연산기, ALU), 제어 유닛, 레지스터 등으로 구성
-
복잡한 명령어와 논리적 작업 처리에 최적화
-
일반적으로 코어가 여러 개(듀얼코어, 쿼드코어 등) 존재
-
일반적인 데이터 처리와 시스템 관리를 담당
-
2. GPU (Graphics Processing Unit, 그래픽 처리장치)
-
이미지를 렌더링하고 그래픽 관련 연산을 빠르게 처리하는 장치입니다.
-
역할: 대량의 연산(특히 행렬/벡터 연산)이 필요한 그래픽 작업이나, 병렬 컴퓨팅(딥러닝, 인공지능 학습 등)에 적합
-
특징
-
수백~수천 개의 코어로 구성 → 병렬 연산에 뛰어남
-
그래픽, 비디오 렌더링 또는 대규모 데이터 병렬 처리에 사용
-
최근에는 GPGPU(범용 GPU 연산)로 과학계산, 딥러닝 등에도 활용
-
3. HBM (High Bandwidth Memory, 고대역폭 메모리)
-
기존 DRAM(DDR, GDDR 등) 대비 훨씬 더 높은 데이터 전송 속도와 낮은 전력 소모를 갖는 차세대 메모리 규격입니다.
-
역할: 주로 고성능 GPU, AI/딥러닝, 서버 등에서 데이터 병목 현상을 줄이기 위해 사용됩니다.
-
특징
-
메모리 칩 여러 개를 3D로 적층하여 TSV(Through Silicon Via) 기술로 연결
-
매우 넓은 데이터 버스(1024bit 등) 덕분에 높은 전송 속도 확보 (예: HBM2 기준 최대 256GB/s 이상)
-
낮은 전력 소비
-
대표적 용도: 최신 그래픽카드(NVIDIA, AMD), AI 가속기, 고성능 서버
-
비교 요약
| 구분 | CPU | GPU | HBM |
|---|---|---|---|
| 역할 | 범용 연산, 제어 | 병렬 연산, 그래픽/AI | 고속 메모리 |
| 구조 | 소수의 강력한 코어 | 수백/수천 개의 단순 코어 | 3D적층, 초고속 버스 |
| 속도 | 낮음~중간 | 높음(병렬) | 매우 높음(메모리) |
| 용도 | 운영체제, 일반 연산 | 영상처리, AI연산, HPC | GPU/CPU 메모리 |
HBM(High Bandwidth Memory)란?
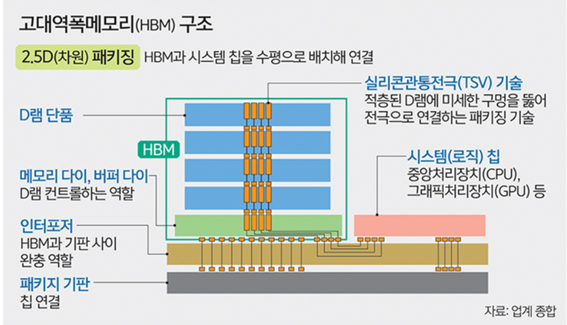
1. 개념 및 등장 배경
-
HBM(고대역폭 메모리)은 기존 메모리의 한계(대역폭, 전력 소모, 크기)에 대응하기 위해 개발된 차세대 메모리 기술입니다.
- 기존 그래픽 메모리(GDDR5 등)는 속도를 올리다보면 전력 소모와 발열이 급격하게 증가하고, 메모리 칩 간 통신 한계 때문에 물리적 레이아웃에 제한이 생겼습니다.
-
이에 따라 높은 대역폭, 낮은 전력, 소형화라는 목표를 가지고 2013년 SK 하이닉스와 AMD가 처음 개발 및 표준화( JEDEC 표준) 했습니다.
2. 구조적 특징
1) 3D 적층 구조
-
HBM은 여러 개의 DRAM 다이를 ‘위로’ 쌓아올리는 3D 적층 기술을 사용합니다.
-
각 다이(칩)는 ‘TSV(Through Silicon Via, 실리콘 관통 전극)’라는 수직 전극 미세구멍으로 연결됩니다.
-
덕분에 데이터가 위아래 방향으로 빠르게 이동할 수 있습니다.
2) 인터포저(Interposer)
-
HBM 스택은 GPU(또는 CPU)와 ‘실리콘 인터포저’ 위에 나란히 배치됩니다.
-
인터포저는 집적회로와 메모리 사이에서 초고속 신호를 주고받는 브리지 역할을 합니다.
3) 넓은 메모리 버스폭
-
GDDR5(32비트~64비트)와 달리 HBM은 1024비트 이상의 초대형 인터페이스를 가집니다.
-
메모리 뱅크(채널)도 8개(HBM), 16개(HBM2) 등으로 늘려서 데이터를 동시에 많이 처리할 수 있습니다.
3. 성능적 장점
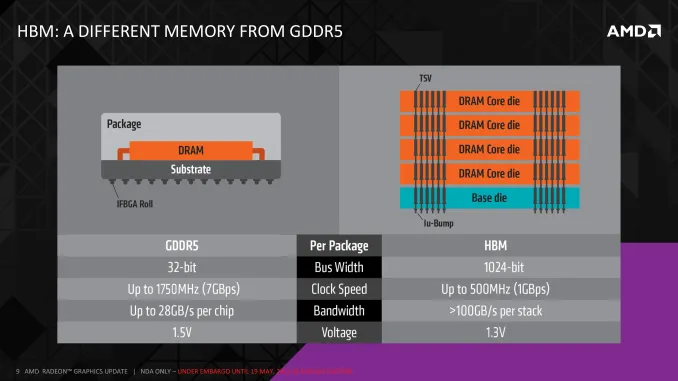
| 비교 항목 | GDDR5 | HBM1 | HBM2 |
|---|---|---|---|
| 데이터 버스폭 | 최대 384bit (일반) | 1024bit (스택 당) | 1024bit (스택 당) |
| 대역폭(스택 기준) | 28GB/s(칩 당) | 128GB/s(칩 당) | 256~460GB/s(칩 당) |
| 소비전력 | 1.5~2.5V | 약 1.2V | 약 1.2V |
| 집적도 | 제한적 | 4단 스택 | 8단 스택까지 가능 |
-
대역폭이 비약적으로 증가하여, 동일 환경에서 데이터를 더욱 빠르게 처리할 수 있음
-
전력 소모가 기존 대비 크게 줄어듦
-
인터포저 설계로 인해 메모리와 프로세서 간 물리적 거리가 짧아짐(지연시간 감소)
-
체적이 작기 때문에 동일 면적에 더 많은 메모리 탑재 가능
4. HBM의 주요 적용 분야
-
고성능 GPU: NVIDIA, AMD, 인텔 등 최신 그래픽 카드(특히 데이터센터용, AI훈련용)에 널리 적용
-
AI/딥러닝 가속기: 구글 TPU, 엔비디아 A100 등
-
슈퍼컴퓨터/서버: 동시처리 및 대용량 데이터 병렬처리 필요 환경
-
네트워크 장비, FPGA 등: 초고속 통신이 필요한 특수 목적 장비
5. HBM의 한계 및 단점
-
비용: TSV, 인터포저 등 첨단 공정 때문에 생산 단가가 매우 높습니다.
-
설계 복잡성: 시스템 설계, 수율(불량률) 문제가 존재
-
확장성: 기존 DIMM(RAM 슬롯)에 끼우는 방식이 아니라, 칩 제조 단계에서 결합되어야 합니다.
-
발열: 고집적화 특성상 발열 관리도 중요한 과제입니다.
6. 최신 동향
HBM은 기존 메모리 대비 극적으로 높은 대역폭과 낮은 전력을 가지는 3D 적층형 메모리로, 주로 GPU와 AI가속기, 슈퍼컴퓨터 등에 사용되며, 차세대 컴퓨팅 구현에 핵심적인 역할을 하고 있습니다.
-
현재 HBM3, HBM3E까지 상용화(2024~2025 기준)
-
삼성, SK 하이닉스, 마이크론 등이 경쟁적으로 개발
-
대역폭, 용량, 전력 효율 지속 향상 중
-
AI/클라우드, LLM(대규모 언어 모델, 예: ChatGPT) 등의 확산으로 수요 급증
